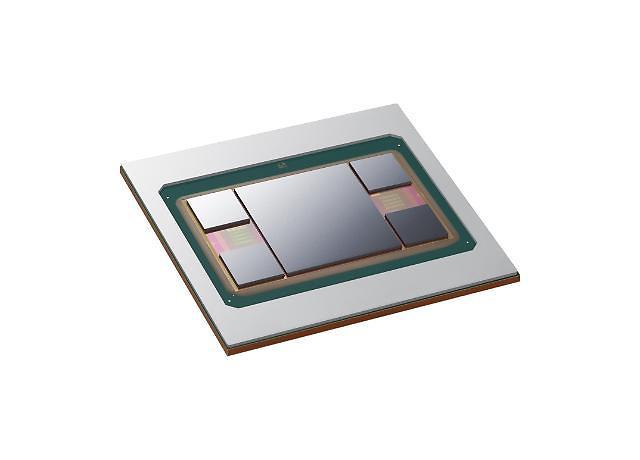
[サムスン電子、次世代半導体パッケージ技術「アイキューブ4」開発…ファウンドリ領域の拡大]
サムスン電子がロジックチップと4つの高帯域幅メモリ(HBM)チップを一つのパッケージに具現した独自の構造の2.5Dパッケージ技術「アイキューブ4(I-Cube4)」を開発した。既存の3次元積層技術である「エックスキューブ(X-Cube)」に加えて新技術を公開し、ファウンドリ領域を拡大している。
6日、サムスン電子によると、アイキューブ4にシリコンインターポーザを適用して超微細配線を具現し、半導体駆動に必要な電力も安定的に供給できるようにした。
サムスン電子の2.5Dパッケージソリューションブランドのアイキューブ4はシリコンインターポーザの上にCPU、GPUなどのロジックとHBMを配置し、一つの半導体のように動作するようにする異種集積化パッケージ技術だ。これを通じ、複数のチップを1つのパッケージ内に配置し、伝送速度は高め、パッケージ面積は減らすことができる。
インターポーザはICチップと印刷回路基板(PCB)の間に追加的に挿入する微細回路基板を意味し、相互間の回路幅差を緩衝させる役割をする。
一般的にパッケージ内に実装する半導体チップが多くなるほど、インターポーザの面積も共に増加し、工程上の難しさも大きくなる。サムスン電子は100マイクロメートル水準の非常に薄いインターポーザが変形しないように材料、厚さなど多様な側面で半導体工程・製造ノーハウを適用した。
また、アイキューブ4にモールドを使用しない独自の構造を適用し、熱を効率的に放出するようにした。モールドは熱硬化性樹脂を使用してチップを包む素材で、チップを保護するための工程である。
サムスン電子はパッケージ工程の中間段階で動作テストを実施し、不良を事前に選び出し、全体工程段階を減らし、生産期間を短縮した。
今回開発したアイキューブ4は高帯域幅のデータ伝送と高性能システム半導体を要求するHPC、人工知能(AI)、クラウドサービス、データセンターなどを中心に幅広く活用されるものと期待される。
<亜洲日報の記事等を無断で複製、公衆送信 、翻案、配布することは禁じられています。>
